[ad_1]
Las tecnologías de empaquetado de semiconductores han evolucionado desde los niveles iniciales de PCB 1D hasta el empaquetado de enlaces híbridos 3D a nivel de oblea de última generación. Este nuevo desarrollo permite distancias de conexión en el rango de un solo dígito micrométrico y alcanza un ancho de banda de más de 1000 GB/s con una alta eficiencia energética.
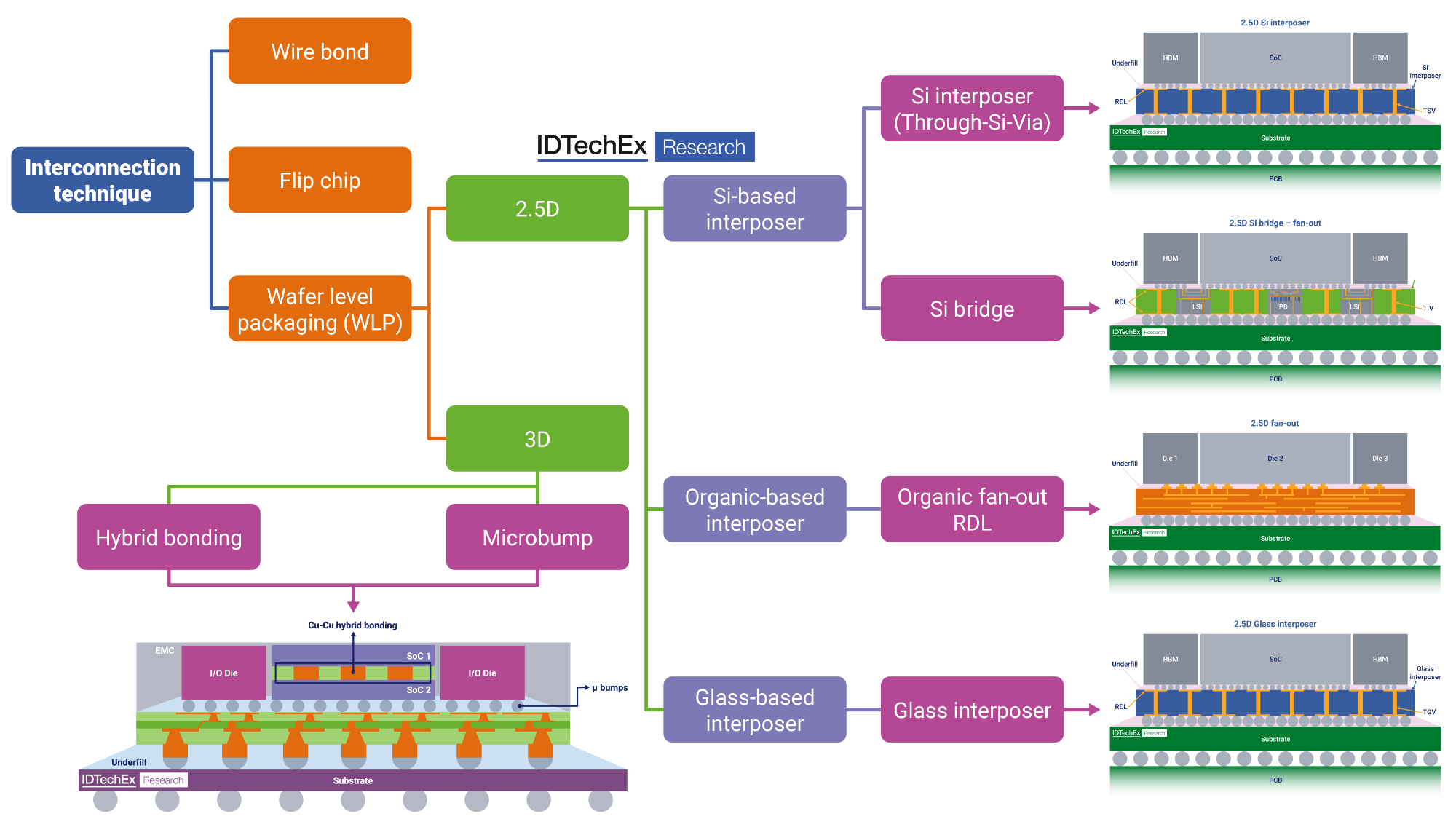
Cuatro parámetros cruciales dan forma al empaquetado de semiconductores avanzados: potencia, rendimiento, área y costo:
- Rendimiento: Aumento de la eficiencia energética a través de tecnologías de embalaje innovadoras.
- Rendimiento: Aumentar el ancho de banda y reducir la longitud de la comunicación al acortar la distancia de conexión para más puntos de entrada/salida (E/S).
- Área: Se requiere un área de empaque más grande para los chips utilizados en áreas informáticas de alto rendimiento, mientras que se requiere un factor de forma Z más pequeño para la integración 3D.
- Costo: Reducir continuamente los costos de embalaje mediante el uso de materiales alternativos y más asequibles o mejorando la eficiencia de las instalaciones de producción.
Tecnología de embalaje 2.5D y 3D:
Las tecnologías de embalaje 2,5D y 3D incluyen diferentes técnicas de embalaje.
Para envases 2,5D, la elección del material de intercalación se divide en intercaladores a base de Si, orgánicos y de vidrio, como se muestra en la figura anterior. Mientras tanto, el mayor desarrollo de la tecnología microbump en envases 3D tiene como objetivo dimensiones de paso más pequeñas. Sin embargo, ahora es posible lograr dimensiones de paso de un solo dígito gracias a la introducción de la tecnología de enlace híbrido, un método que une directamente Cu-Cu, lo que representa un avance significativo en el campo.
Pros y contras de cada tipo de embalaje en configuraciones 2,5D y 3D
2.5D
Si: Dentro de esta categoría hay dos alternativas: el intercalador de Si, que utiliza una oblea de Si completamente pasiva, y el puente de Si, que puede aceptar la forma de un puente de Si localizado en un compuesto de moldeo basado en abanico o en un sustrato con una cavidad. El intercalador de Si, ampliamente utilizado en paquetes 2.5D para la integración informática de alto rendimiento debido a su capacidad para habilitar las mejores funciones de enrutamiento, enfrenta desafíos relacionados con su material y costos de fabricación en comparación con alternativas como los materiales orgánicos y el espacio de empaque limitado. Para abordar este problema, la forma de puente de Si localizado se está volviendo cada vez más importante y utiliza Si estratégicamente donde las estructuras finas son esenciales. Además, se espera que la estructura del puente de Si tenga un uso cada vez mayor, particularmente en escenarios donde el intercalador de Si enfrenta limitaciones de área más allá del límite de la retícula de 4x o 5x.
Biografía: En el informe analizamos específicamente los envases de base orgánica que utilizan un compuesto de moldeo en abanico en lugar de un sustrato orgánico. Los materiales orgánicos que pueden ajustar su constante dieléctrica a un valor más bajo que el silicio contribuyen a un menor retraso de RC en el paquete. Además, estos materiales representan una alternativa más rentable al silicio, y estas ventajas están impulsando la aparición de envases 2,5D de base biológica. Sin embargo, un inconveniente importante radica en los desafíos asociados con lograr el mismo nivel de reducción de características de interconexión que los paquetes basados en Si.
Vaso: El enfoque basado en vidrio ha atraído mucho interés después de que Intel presentara su paquete de vehículo de prueba basado en vidrio a principios de este año. El vidrio tiene propiedades beneficiosas que incluyen un coeficiente ajustable de expansión térmica (CTE), alta estabilidad dimensional y una superficie lisa y plana. Estas propiedades hacen del vidrio un candidato prometedor para su uso como intercalador, con capacidades de enrutamiento que tienen el potencial de rivalizar con las del silicio. Sin embargo, la principal desventaja del vidrio radica en su ecosistema inmaduro y la actual falta de capacidades de producción en masa en la industria del embalaje. Sin embargo, el uso de tecnologías basadas en vidrio en envases de semiconductores podría seguir aumentando a medida que el ecosistema madure y aumente la capacidad de producción.
3D
Microgolpe: La consolidada tecnología microbump, basada en el proceso de unión por compresión térmica (TCB), está presente desde hace mucho tiempo en varios productos. La hoja de ruta prevé una ampliación continua del terreno de juego. Sin embargo, presenta un desafío crítico ya que los tamaños más pequeños de bolas de soldadura en este proceso conducen a una mayor formación de compuestos intermetálicos (IMC) y deterioran la conductividad y las propiedades mecánicas. Además, los espacios de contacto estrechos pueden provocar puentes en las bolas de soldadura, lo que crea el riesgo de fallo del chip durante la soldadura por reflujo. Dado que la soldadura y el IMC tienen una resistencia específica mayor que el cobre, su uso en carcasas de componentes de alto rendimiento tiene sus límites.
Enlace híbrido: Los enlaces híbridos crean conexiones permanentes combinando un material dieléctrico (SiO2) con metal incrustado (Cu). Debido a que el enlace híbrido Cu-Cu alcanza distancias inferiores a 10 micrones (normalmente alrededor de un solo dígito µm), los beneficios incluyen E/S expandidas, mayor ancho de banda, apilamiento vertical 3D mejorado, mayor eficiencia energética y reducción de parásitos y resistencia térmica debido a la falta de Llenado insuficiente. Los desafíos incluyen la complejidad de la fabricación y los mayores costos asociados con esta técnica avanzada.
El nuevo informe de IDTechEx, «Embalaje de semiconductores avanzado 2024-2034: pronósticos, tecnologías, aplicaciones», examina en profundidad las últimas innovaciones en tecnología de embalaje de semiconductores, cubre tendencias técnicas clave, analiza la cadena de valor, evalúa a los actores clave y ofrece pronósticos de mercado detallados.
El informe reconoce el papel fundamental del empaquetado de semiconductores avanzados como base para los circuitos integrados de próxima generación. La atención se centra en sus aplicaciones en mercados clave como la inteligencia artificial y los centros de datos, 5G, vehículos autónomos y electrónica de consumo. El informe aprovecha la experiencia de IDTechEx en estos sectores y proporciona una comprensión integral del impacto y el desarrollo futuro de los envases de semiconductores avanzados en estas áreas críticas.
Aspectos clave de este informe:
Explorando tendencias tecnológicas y fabricantes en envases de semiconductores avanzados:
- Descubra el desarrollo de paquetes de semiconductores avanzados y supere los desafíos de los circuitos integrados de transistores. Explore cómo los conceptos de chiplet y la integración heterogénea están impulsando la adopción de empaques avanzados.
- Análisis de tecnologías de embalaje: segmentación por material intercalador (Si, vidrio, orgánico), teniendo en cuenta hojas de ruta, benchmarks, aplicaciones, jugadores y barreras de fabricación.
- Análisis de Empresas: Estudio en profundidad de empresas clave, evaluando soluciones, clientes, aplicaciones y hoja de ruta tecnológica.
- Mercados clave: proporcione descripciones detalladas de los mercados críticos: informática de alto rendimiento, vehículos autónomos, 5G y electrónica de consumo.
- Estudios de caso: presente diversas aplicaciones industriales de envases de semiconductores avanzados.
- Cadena de suministro y modelos: analice la dinámica de la cadena de suministro y los modelos comerciales en este panorama en evolución.
Pronósticos y análisis granulares del mercado a 10 años:
- Pronóstico de la unidad de servidores del centro de datos 2023-2034 (entrega)
- CPU del centro de datos: pronóstico de embalaje de semiconductores avanzados 2023-2034 (envío)
- Acelerador de centros de datos: pronóstico de embalaje de semiconductores 2023-2034 (envío)
- Paquete de semiconductores 2.5D para vehículos autónomos L4+ 2023-2045
- Embalaje de semiconductores 3D para vehículos autónomos L4+ 2023-2045
- Previsión de ventas de dispositivos electrónicos de consumo 2023-2034 (smartphones/tablets/
Relojes inteligentes/AR/VR/MR) - Pronóstico de empaques de semiconductores avanzados para APE en electrónica de consumo 2023-2034
- Pronóstico de envío mundial de PC 2023-2034
- Embalaje de semiconductores avanzados en PC Pronóstico 2023-2034
- Pronóstico de radio 5G por unidad de tamaño MIMO 2023-2034
- Embalaje de semiconductores avanzado para redes RAN 5G 2023-2034
Fuente: https://www.idtechex.com/
[ad_2]